Go List
 2024-12-09
2024-12-09功率器件熱設計基礎(一)功率半導體的熱阻
來源: 英飛凌工業半導體
/ 前言 /
功率半導體熱設計是實現 IGBT、碳化矽 SiC 高功率密度的基礎,只有掌握功率半導體的熱設計基礎知識,才能完成精確熱設計,提高功率器件的利用率,降低系統成本,並保證系統的可靠性。
功率器件熱設計基礎系列文章會比較系統地講解熱設計基礎知識,相關標準和工程測量方法。
散熱
功率半導體器件在開通和關斷過程中和導通電流時會產生損耗,損失的能量會轉化為熱能,表現為半導體器件發熱,器件的發熱會造成器件各點溫度的升高。
半導體器件的溫度升高,取決於產生熱量多少(損耗)和散熱效率(散熱通路的熱阻)。
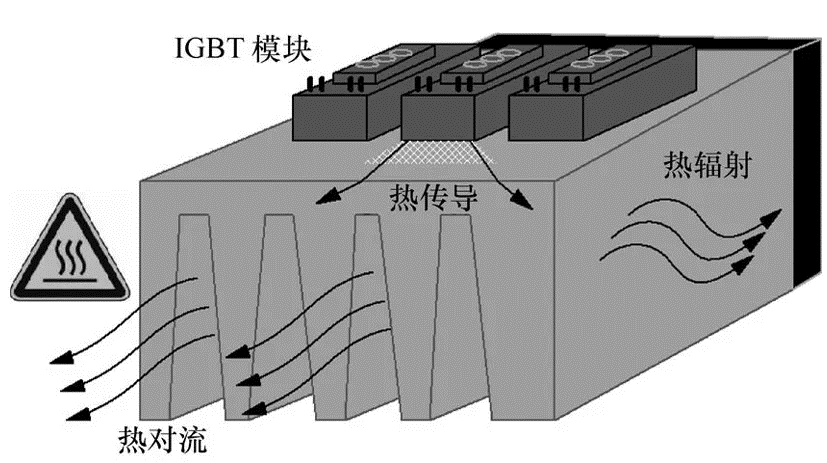
IGBT 模組的風冷散熱是典型的散熱系統,同時包含了散熱的形式三種:熱傳導、熱輻射和熱對流。
熱傳導:
熱傳導是指固體或液體之間因為溫度差而產生熱量傳遞或擴散的現象。熱傳導的特性可以類比為電氣工程中的歐姆定律,如圖所示。熱能工程中的熱源就像電氣工程中的電源,熱能工程中的受熱體就像是電氣工程中的負載,電氣工程有電阻電容元件,熱能工程也有類似屬性的元件,稱為熱阻和熱容。
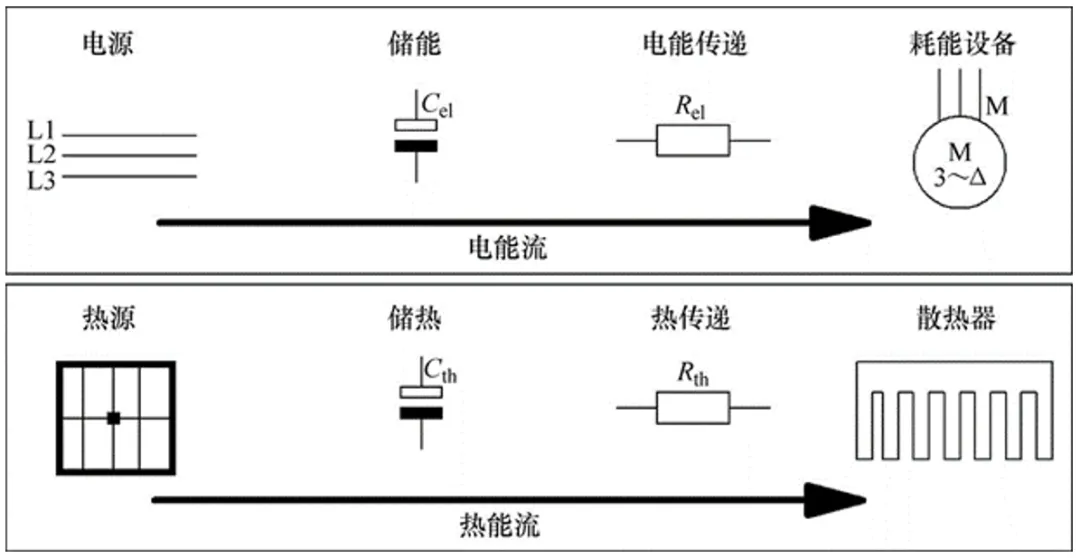
熱阻:
熱阻是一個在熱傳導中至關重要的概念,它描述了物質對熱傳導的阻力,為傳熱過程中溫度差與熱流量比值。這一參數在電子元器件設計、散熱方案設計等多個領域都扮演著重要角色。

Rth = 熱阻
P(Pth,C) = 功率(熱流量)
ΔT = 溫差
這個定義,就與電路中的歐姆定律一致:

不同介質(固體、液體或氣體)導熱能力不同,以熱的形式傳輸熱能的能力定義為導熱係數 λ。因為導熱係數是介質的特性,所以某種材料的導熱係數可以看作是一個常數。導熱係數又稱熱導率,單位是 W/(m·K)。下表給出了一些材料的 λ 值。

從上表可以看到功率半導體常用材料的導熱係數,如矽的導熱係數是 100W/(m·K),而碳化矽的導熱係數是 490W/(m·K),所以說碳化矽散熱性比矽好很多,且優於金屬銅 25%,甚至比金屬銀還好。
熱阻與導熱係數:
熱阻與導熱介質的橫截面積A成反比,與厚度d成正比,其單位是K/W:

金屬鋁和銅有很好的導熱性,常用於製作功率半導體的散熱器,但再好的導體也會引入熱阻,而且厚度越大,熱阻越高。
有了熱阻和導熱係數的概念,就可以與產品聯繫起來了:
實例一
功率模組的結構和熱阻
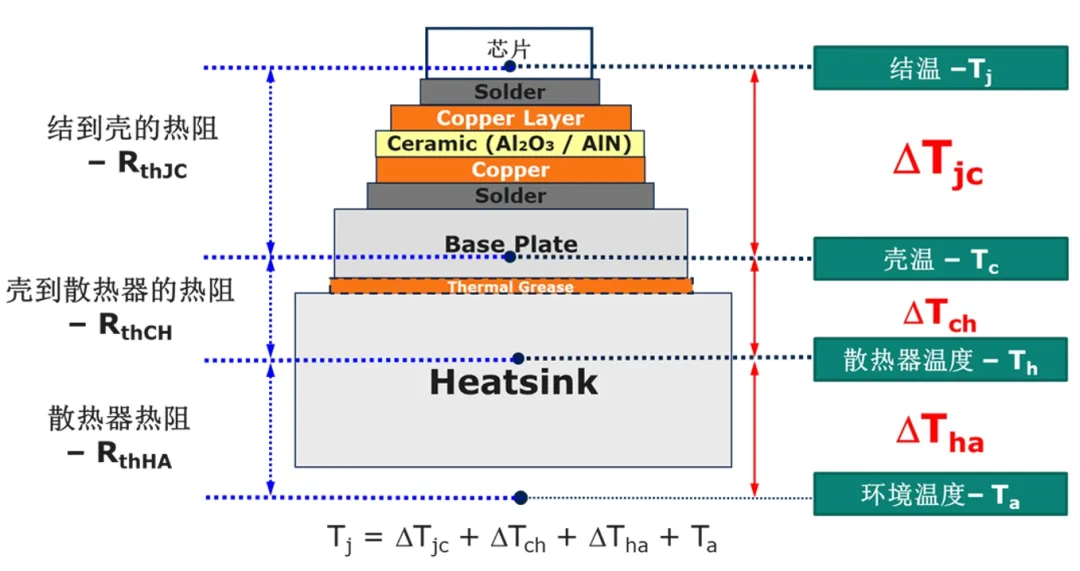
熱阻是由材料導熱係數,厚度,面積決定的,一個實際帶銅基板的IGBT功率模組的熱阻分佈如下圖所示,晶片焊料導熱性並不好,導熱係數 30W/(m·K)左右,但很薄,厚度往往只有 0.1mm,所以在功率模組中熱阻只占 4%。而 DCB 中的陶瓷導熱係數 25 W/(m·K),與焊料差得不多,但厚度有 0.38mm,幾乎是焊接層的 4 倍,所以熱阻占比高達 28%。

我們在定義模組殼到散熱器的熱阻時,假設導熱矽脂的導熱係數是 1W/(m·K),厚度為 30-100um,在晶片的散熱通路中,其占比高達 37%,是最大的部分。所以用更好的導熱材料緩解散熱瓶頸,提高功率密度的重要舉措,這為什麼英飛凌提供預塗導熱材料的模組。

實例二
晶片厚度與熱阻
同樣我們也可以模擬分析一下,晶片厚度對熱阻的影響。
為了簡化問題,我們用採用擴散焊的單管為例,其結構簡單。由於採用擴散焊,熱阻主要由晶片和銅框架構成,模擬條件:假設矽晶片的面積 5.1mm² ,矽的晶片厚度分別為 350um 和 110um,晶片損耗 170W。
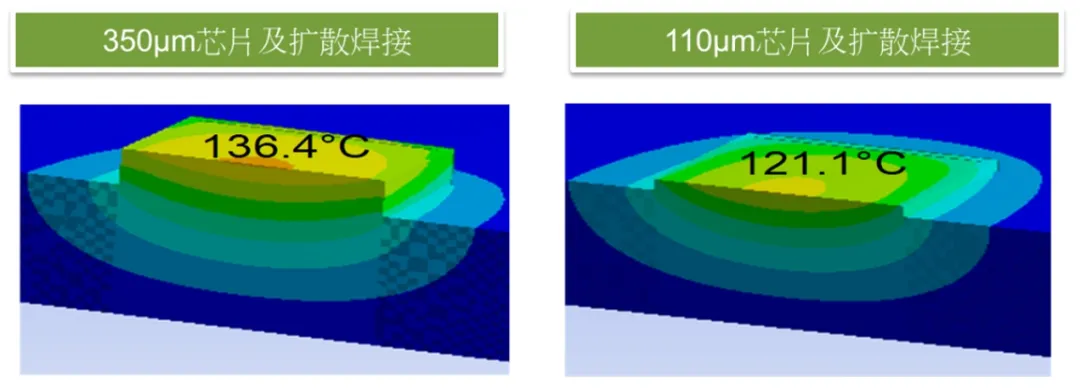
可以直觀地看清矽導熱性不是特別好,相同條件下,350um 的晶片要比 110um 晶片溫度高 15 度,原因是晶片的厚度造成的熱阻增大。
但器件的耐壓與漂移區的長度和電阻率有關,太薄的晶圓意味著更低的耐壓,太厚漂移區漂移區電阻也更大,熱阻也增加,英飛凌開發 IGBT 薄晶圓技術就是一種完美的設計。
實例三
SiC 碳化矽晶片的熱優勢
功率開關器件的耐壓與其漂移區的長度和電阻率有關,而 MOSFET 是單極性功率開關器件,其通態電阻又直接決定于漂移區的長度和電阻率,與其製造材料臨界擊穿電場強度的立方成反比。因為 4H-SiC 有 10 倍於 Si 的臨界擊穿電場強度,因此基於 SiC 的功率器件允許使用更薄的漂移區來維持更高的阻斷電壓,從而顯著降低了正向壓降以及導通損耗,同時減小熱阻。
做一個 paper design 例子,如果要獲得 5000V 的耐壓,使用摻雜為 2.5*1013/cm3 的襯底材料,Si 基功率器件需要漂移層厚度 0.5mm,單位面積電阻為 10Ωcm2;SiC MOSFET 使用摻雜為 2.0*1015/cm3 的漂移層,需要的厚度僅有 0.05mm,單位面積電阻僅為 0.02Ωcm2。
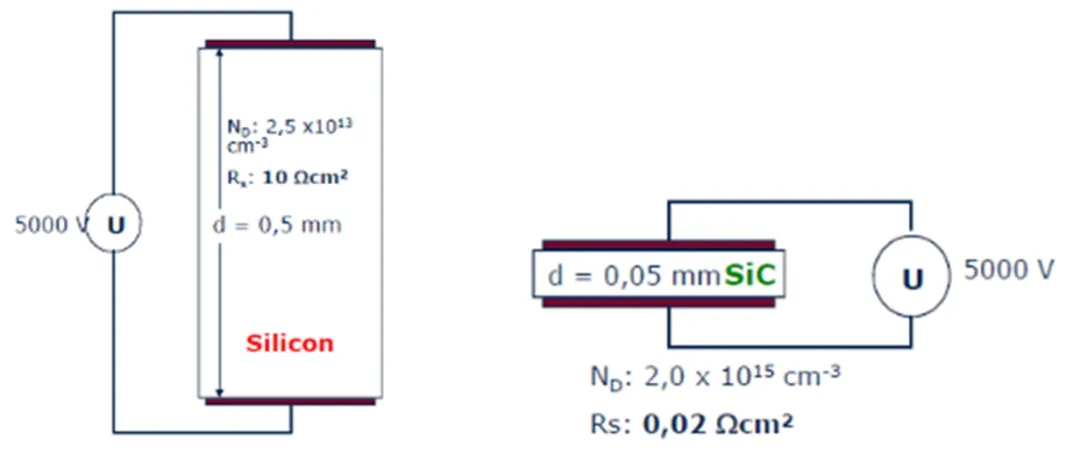
同時碳化矽的導熱係數是 490W/(m·K),所以碳化矽晶片可以實現很高的功率密度,就是說,晶片面積很小,也可以保證晶片的散熱。
SiC 的禁帶寬度 3.23ev,相應的本征溫度可高達 800 攝氏度。如果能夠突破材料及封裝的溫度瓶頸,則功率器件的工作溫度將會提升到一個全新的高度。
掃描二維碼,關注英飛凌工業半導體尋找更多應用或產品資訊
